| Что такое MOSFET? |
|---|
Кратко MOSFET(metal–oxide–semiconductor field-effect transistor)- Металл Оксид Полупроводник полевой транзистор.
Очень мощные транзисторы для коммутации больших токов. И чем больше корпус - тем на больший ток он рассчитан.
Как работают транзисторы MOSFET?
Мощные транзисторы MOSFET хорошо известны своей исключительной скоростью переключения при весьма малой мощности управления, которую нужно прикладывать к затвору. Основная причина в том, что затвор изолирован, поэтому требуется мощность только на перезаряд емкости затвор-исток, и в статическом режиме цепь затвора практически не потребляет тока. В этом отношении мощные MOSFET по своим характеристикам приближаются к "идеальному переключателю". Основные недостатки, которые не дают MOSFET стать "идеальным", это сопротивление открытого канала RDS(on), и значительная величина положительного температурного коэффициента (чем выше температура, тем выше сопротивление открытого канала).
Для того, чтобы было проще понять работу полевого N-канального транзистора MOSFET, его стоит сравнить с широко распространенным биполярным кремниевым транзистором структуры NPN. Электроды у биполярного транзистора называются база, коллектор, эмиттер, а у полевого транзистора затвор, сток, исток.
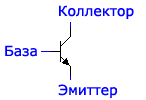
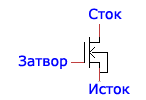
База выполняет те же функции, что и затвор, коллектор соответствует стоку, а эмиттер соответствует истоку.
Давайте рассмотрим простейшую схему включения транзистора NPN:
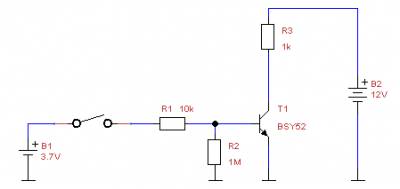
Когда входной ключ разомкнут, то через эмиттерный переход транзистора T1 ток не течет, и канал коллектор-эмиттер имеет высокое сопротивление. Говорят, что транзистор закрыт, через его канал коллектор-эмиттер ток практически не течет. Когда замыкается входной ключ, то от батарейки B1 через резистор R1 и эмиттерный переход транзистора течет открывающий ток. Когда транзистор открыт, то его сопротивление канала коллектор-эмиттер уменьшается, и почти все напряжение батареи B2 оказывается приложенным к нагрузке R3. Т. е. когда во входной цепи течет ток (через R1), то в выходной цепи тоже течет ток (через R3), но в выходной цепи ток и напряжение (т. е. действующая мощность) в несколько раз больше. Здесь как раз и проявляются усиливающие свойства транзистора - маленькая мощность на входе позволяет управлять большой мощностью на выходе.
А так будет в этой схеме работать транзистор MOSFET:
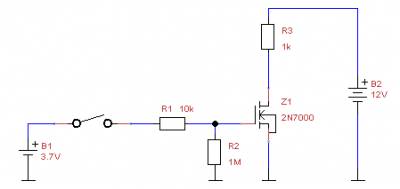
На первый взгляд все то же самое - когда на входе есть управляющая мощность, она также появляется и на выходе (обычно усиленная во много раз). В этом смысле биполярный транзистор и MOSFET-транзистор очень похожи. Но есть два самых важных различия:
• Биполярный транзистор управляется током, а полевой транзистор напряжением.
Примечание: отсюда, кстати и пошло название полевого транзистора: его канал управляется не током, а электрическим полем затвор-исток.
Это означает, что входное сопротивление биполярного транзистора мало, а входное сопротивление MOSFET-транзистора очень велико. Обратите внимание на входной ток биполярного транзистора - 0.3 мА, этот ток в основном определяется сопротивлением резистора R1. Причина проста: на входе у биполярного транзистора имеется эмиттерный переход, который по сути обыкновенный диод, смещенный в прямом направлении. Если ток через этот диод есть, то транзистор открывается, если нет, то закрывается. Открытый диод имеет малое сопротивление, и максимальное падение напряжения на нем составляет около 0.7V. Поэтому практически все напряжение B1 (если быть точным, то 3.7 - 0.7 = 3V) оказывается приложенным к резистору R1. Этот резистор играет роль ограничителя входного тока биполярного транзистора.
У полевого транзистора MOSFET в этом отношении все по-другому. Входной ток определяется главным образом сопротивлением резистора R2, поэтому входной ток очень мал. Практически все входное напряжение оказывается приложенным к R2 и к переходу затвор - исток полевого транзистора. Причина проста: затвор и исток изолированы друг от друга слоем оксида кремния, по сути это конденсатор, поэтому ток через затвор практически не течет.
По этой причине на низких частотах, когда входная емкость не шунтирует источник сигнала, полевой транзистор имеет гораздо большее усиление по мощности в сравнении с биполярным транзистором. И действительно, в нашем примере входная мощность у биполярного транзистора составляет 0.3 мА * 3.7V = 1.11 мВт, а у полевого транзистора входная мощность составит всего лишь 0.00366 мА * 3.7V = 0.0135 мВт, т. е. в 82 раза меньше! Это соотношение могло бы быть еще больше не в пользу биполярного транзистора, если увеличить сопротивление резистора R2.
• Падение напряжения на выходном канале у полевого транзистора намного меньше, чем у биполярного.
Для данного примера падение напряжения коллектор-эмиттер биполярного транзистора составит примерно 0.3V, а у полевого 0.1V и даже меньше. Обычно выходное сопротивление у полевого транзистора намного меньше, чем у биполярного.
Исходном состоянии, когда на затворе относительно истока нулевое положительное напряжение, сопротивление канала определяется количеством неосновных носителей в полупроводнике, и очень велико. Когда к затвору прикладывается положительное напряжение относительно истока, то появляется проводящий ток канал сток-исток. Поэтому MOSFET иногда называют полевым транзистором с индуцированным каналом.
[Структура мощного транзистора MOSFET]
На рис. 1 показан срез структуры N-канального транзистора MOSFET компании Advanced Power Technology (APT). (Здесь рассматриваются MOSFET только N-структуры, как самые популярные.) Положительное напряжение, приложенное от вывода истока (source) к выводу затвора (gate), заставляет электроны притянуться ближе к выводу затвора в области подложки. Если напряжение исток-затвор равно или больше определенного порогового напряжения, достаточного для накапливания нужного количества электронов для достижения инверсии слоя n-типа, то сформируется проводящий канал через подложку (говорят, что канал MOSFET расширен). Электроны могут перетекать в любом направлении через канал между стоком и истоком. Положительный (или прямой) ток стока втекает в сток, в то время как электроны перемещаются от истока к стоку. Прямой ток стока будет заблокирован, как только канал будет выключен, и предоставленное напряжение сток-исток будет прикладываться в обратном направлении к p-n переходу подложка-сток. В N-канальных MOSFET только электроны формируют проводимость, здесь нет никаких не основных носителей заряда. Скорость переключения канала ограничена только длительностью перезаряда паразитных емкостей между электродами MOSFET. Поэтому переключение может быть очень быстрым, приводя к низким потерям при переключении. Этот фактор делает мощные MOSFET такими эффективными для работы на высокой частоте переключения.
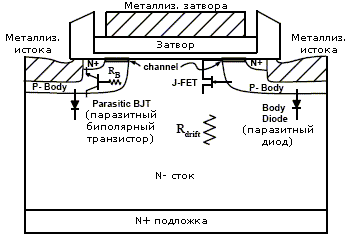
Рис. 1. Срез рабочей структуры транзистора MOSFET.
RDS(on). Основные составляющие, которые входят в сопротивление открытого канала RDS(on), включают сам канал, JFET (аккумулирующий слой), область дрейфа Rdrift, паразитные сопротивления (металлизация, соединительные провода, выводы корпуса). При напряжениях приблизительно выше 150V в сопротивлении открытого канала доминирует область дрейфа. Эффект RDS(on) относительно невелик на высоковольтных транзисторах MOSFET. Если посмотреть на рис. 2, удвоение тока канала увеличивает RDS(on) только на 6%.
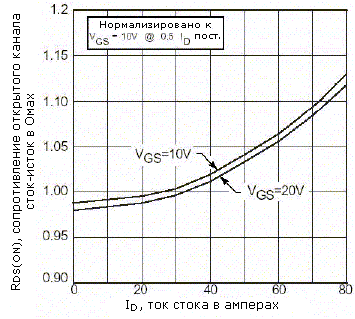
Рис. 2. Зависимость RDS(on) от тока через канал.
Температура, с другой стороны, сильно влияет на RDS(on). Как можно увидеть на рис. 3, сопротивление приблизительно удваивается при возрастании температуры от 25°C до 125°C. Температурный коэффициент RDS(on) определяется наклоном кривой графика рис. 3, и он всегда положителен для большинства поставщиков транзисторов MOSFET. Большой положительный температурный коэффициент RDS(on) определяется потерями на соединении I2R, которые увеличиваются с ростом температуры.
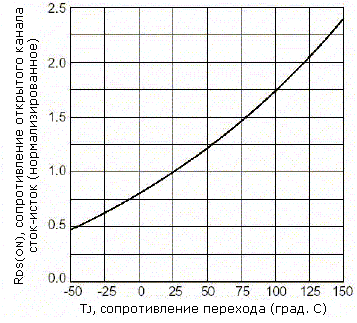
Рис. 3. Зависимость RDS(on) от температуры.
Положительный температурный коэффициент RDS(on) очень полезен, когда нужно параллельно включать транзисторы MOSFET, поскольку это обеспечивает их температурную стабильность и равномерное распределение рассеиваемой мощности между транзисторами. Этим MOSFET выгодно отличаются от традиционных биполярных транзисторов. Но это не гарантирует, что параллельно соединенные транзисторы будут равномерно распределять между собой общий ток. Это широко распространенное заблуждение [2]. То, что действительно делает MOSFET простыми для параллельного включения - это их относительно малый разброс по параметрам между отдельными экземплярами в пределах серии, в частности по параметру RDS(on), в комбинации с более безопасными свойствами канала в контексте перегрузки по току, когда благодаря положительному температурному коэффициенту RDS(on) сопротивление канала растет при повышении температуры.
Для любого заданного размера кристалла RDS(on) также увеличивается с увеличением допустимого напряжения V(BR)DSS, как это показано на рис. 4.
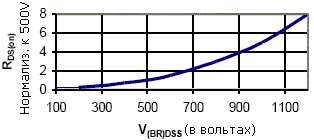
Рис. 4. Зависимость нормализированного RDS(on) от V(BR)DSS.
Кривая нормализированного RDS(on) в зависимости от V(BR)DSS для Power MOS V и Power MOS 7 MOSFET показывает, что RDS(on) растет пропорционально квадрату V(BR)DSS. Эта нелинейная зависимость между RDS(on) и V(BR)DSS является побудительным стимулом для исследования технологий с целью уменьшить потери проводимости мощных транзисторов.
[Внутренние и паразитные элементы]
JFET. В структуре MOSFET Вы можете представить себе встроенный JFET, как это показано на рис. 1. JFET оказывает значительное влияние на RDS(on), и является частью нормального функционирования MOSFET.
Что такое JFET:
JFET расшифровывается как Junction gate Field-Effect Transistor, т. е. полевой транзистор с управлением на основе обратно-смещенного PN-перехода. Это самый простой тип полевого транзистора, который появился раньше всего.
Внутренний диод на подложке (Intrinsic body diode). Переход p-n между подложкой и стоком формирует внутренний диод, так называемый body diode (см. рис. 1), или паразитный диод. Обратный ток стока не может быть блокирован, потому что подложка замкнута на исток, предоставляя мощный путь для тока через body diode. Расширение канала транзистора (при положительном напряжении на затворе относительно истока) уменьшает потери на прохождение обратного тока стока, потому что электроны проходят через канал в дополнение к электронам и неосновным носителям, проходящим через body diode.
Наличие внутреннего диода на подложке удобно в схемах, для которых требуется путь для обратного тока стока (часто называемого как ток свободного хода), таких как схемах мостов. Для таких схем предлагаются транзисторы FREDFET, имеющие улучшенные восстановительные характеристики (FREDFET это просто торговое имя компании Advanced Power Technology, используемое для выделения серий MOSFET с дополнительными шагами в производстве, направленными на ускорение восстановления intrinsic body diode). В FREDFET нет отдельного диода; это тот же MOSFET intrinsic body diode. Для управления временем жизни неосновных носителей во внутреннем диоде применяется либо облучение электронами (наиболее часто используемый вариант) или легирование платиной, что значительно уменьшает заряд обратно смещенного перехода и время восстановления.
Побочный эффект от обработки FREDFET - повышенный ток утечки, особенно на высоких температурах. Однако, если учесть, что MOSFET имеет очень малый начальный ток утечки, то добавленный через FREDFET ток утечки остается допустимым до температур перехода ниже 150°C. В зависимости от дозы облучения FREDFET может иметь RDS(on) больше, чем у соответствующего MOSFET. Прямое напряжение для паразитного диода для FREDFET также немного больше. Заряд затвора и скорость переключения у MOSFET и FREDFET идентичны. Поэтому термин MOSFET здесь будет использоваться всегда для обоих типов MOSFET и FREDFET, если специально не оговорено что-то другое.
Скорость восстановления для паразитного диода у MOSFET или даже у FREDFET намного хуже в сравнении со скоростью быстрого дискретного диода. В приложениях, где жесткие рабочие условия с температурой порядка 125°C, потери на включение из-за восстановления из обратного смещения примерно в 5 раз выше, чем у быстрых дискретных диодов. НА это есть 2 причины:
1. Рабочая область паразитного диода совпадает с рабочей областью MOSFET или FREDFET, и рабочая область у дискретного диода для той же функции намного меньше, поэтому о дискретного диода намного меньше заряд восстановления.
2. Паразитный диод MOSFET или даже FREDFET не оптимизирован под обратное восстановление, как это сделано для дискретного диода.
Как и любой стандартный кремниевый диод, у паразитного диода заряд восстановления и время зависит от температуры, di/dt (скорости изменения тока), и величины тока. Прямое напряжение паразитного диода, VSD, уменьшается с ростом температуры по коэффициенту примерно 2.5 mV/°C.
Паразитный биполярный транзистор. Разделенная на слои структура MOSFET также формирует паразитный биполярный транзистор (BJT) структуры NPN, и его включение на является частью нормального функционирования. Если BJT откроется и войдет в насыщение, то это может вызвать самоблокировку, при которой MOSFET не может быть выключен кроме как через внешний разрыв цепи тока стока. Высокая мощность рассеивания (например, при возникновении сквозного тока в плече моста) при самоблокировке может вывести MOSFET из строя.
Что такое BJT:
BJT расшифровывается как Bipolar junction transistor, т. е. биполярный транзистор. "Биполярным" транзистор называется потому, что его работа основана на переносе зарядов 2 типов - электроны (отрицательный заряд) и дырки (положительный заряд).
База паразитного BJT замкнута на исток, чтобы предотвратить самоблокировку, и потому что напряжение пробоя (breakdown voltage) было бы значительно уменьшено (для того же самого значения RDS(on)), если бы база была оставлена плавающей. Существует теоретическая возможность самоблокировки при очень большой скорости dv/dt в момент выключения. Однако для современных стандартных мощных транзисторов очень трудно создать схему, где будет достигнута такое высокое dv/dt.
Есть риск включения паразитного BJT, если внутренний диод проводит, и затем выключается с чрезмерно высоким изменением dv/dt. Мощная коммутация dv/dt вызывает высокую плотность неосновных носителей заряда (положительные носители, или дырки) в подложке, что может создать напряжение на подложке, достаточное для включения паразитного BJT. По этой причине в даташите указано ограничение пиковой коммутации (восстановление встроенного диода) dv/dt. Пиковая коммутация dv/dt для FREDFET выше в сравнении с MOSFET, потому что у FREDFET снижено время жизни неосновных носителей заряда.
[На что влияет температура]
Скорость переключения. Температура практически не влияет на скорость переключения и потери, потому что (паразитные) емкости мало зависят от температуры. Однако ток обратного восстановления в диоде увеличивается с температурой, так что температурные эффекты внешнего диода (это может быть дискретный диод, или внутренний диод в MOSFET или FREDFET) влияют на потери включения мощных схем.
Пороговое напряжение, или напряжение отсечки (Threshold voltage). Напряжение отсечки затвора, обозначаемое как VGS(th), является важным стандартным параметром. Оно говорит, насколько много миллиампер через сток будет течь при пороговом напряжении на затворе, когда транзистор в основном выключен, но находится на пороге включения. У напряжения отсечки есть отрицательный температурный коэффициент; это означает, что напряжение отсечки уменьшается с ростом температуры. Температурный коэффициент влияет на время задержки включения и выключения, и следовательно влияет на выбор "мертвого времени" в мостовых схемах.
Переходная характеристика (Transfer characteristic). На рис. 5 показана переходная характеристика MOSFET-транзистора APT50M75B2LL.
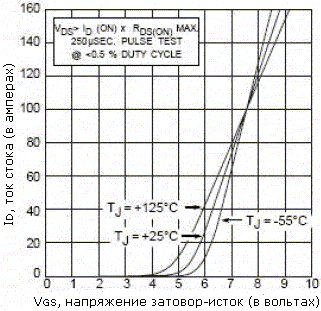
Рис. 5. Пример переходной характеристики MOSFET.
Переходная характеристика зависит как от температуры, так и от тока стока. На рис. 5 при токе ниже 100 A напряжение затвор-исток имеет отрицательный температурный коэффициент (при заданном токе стока уменьшается напряжение затвор-исток при повышении температуры). При токе выше 100 A температурный коэффициент становится положительным. Температурный коэффициент напряжения затвор-исток и ток стока в том месте, где коэффициент меняет знак, важен для проектирования работы схем в линейном режиме [4].
Напряжение пробоя (Breakdown voltage). Напряжение пробоя имеет положительный температурный коэффициент, этот будет обсуждаться в секции Walkthrough.
Устойчивость к перегрузке по току (Short circuit capability). Возможность противостояния коротким замыканиям не всегда встречается в даташите. Причина понятна - MOSFET стандартной мощности не подходят для устойчивой работы в режиме перегрузки по току в сравнению с IGBT или другими транзисторами, работающими с высокой плотностью тока. Само собой разумеется, что MOSFET и FREDFET (в некотором смысле) устойчивы к перегрузке по току.
[Обзор параметров даташита. Максимальные предельные значения]
Назначение даташитов, предоставляемых APT, состоит в предоставлении соответствующей информации, которая полезна и удобна для выбора подходящего устройства в конкретном приложении. Предоставляются графики, чтобы можно было экстраполировать от одного набора рабочих условий к другому. Следует отметить, что графики предоставляют типичную производительность, но не минимумы или максимумы. Производительность также зависит кое в чем от схемы; различные тестовые схемы приведут к отличающимся результатам.
VDSS, напряжение сток-исток. Это оценка максимального напряжения сток-исток не вызывая лавинного пробоя (avalanche breakdown) с затвором, замкнутым на исток при температуре 25°C. В зависимости от температуры напряжение лавинного пробоя могло бы быть фактически меньше, чем параметр VDSS. См. описание V(BR)DSS в разделе "Статические электрические характеристики".
VGS, напряжение затвор-исток. Это предельное напряжение между выводами затвора и истока. Назначение этого параметра - предотвратить повреждение изолирующего оксидного слоя затвора (например, от статического электричества). Фактическая устойчивость оксидной пленки затвора намного выше, чем заявленный параметр VGS, но он варьируется в зависимости от производственных процессов, так что если укладываться в предел VGS, то это гарантирует надежную работу приложения.
ID, непрерывный ток стока. ID определяет максимальный уровень продолжающегося постоянного тока, когда транзистор выходит из строя при максимальной температуре перехода TJ(max), для случая 25°C, и иногда для более высокой температуры. Он основан на термосопротивлении между корпусом и переходом RӨJC, и для случая температуры TC может быть вычислен по формуле:

Это выражение просто говорит о том, какая максимальная мощность может рассеиваться

при максимальной генерируемой теплоте из-за потерь в соединении I2D X RDS(on)@TJ(max), где RDS(on)@TJ (max) сопротивление открытого канала при максимальной температуре перехода. Отсюда можно вывести ID:
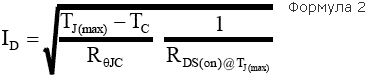
Обратите внимание, что в ID не входят никакие потери на переключение, и случай с температурой 25°C на практике встречается редко. По этой причине в приложениях, где MOSFET часто переключается, фактический коммутируемый ток обычно меньше половины ID @ TC = 25°C; обычно между 1/4 до 1/3.
Зависимость ID от TC. Этот график просто отражает формулу 2 для диапазона температур. Здесь также не учтены потери на переключение. На рис. 6 приведен пример такого графика. Обратите внимание, что в некоторых случаях выводы корпуса транзистора ограничивают максимально допустимый продолжительный ток (переключаемый ток может быть больше): 100 A для корпусов TO-247 и TO-264, 75 A для TO-220 и 220 A для SOT-227.
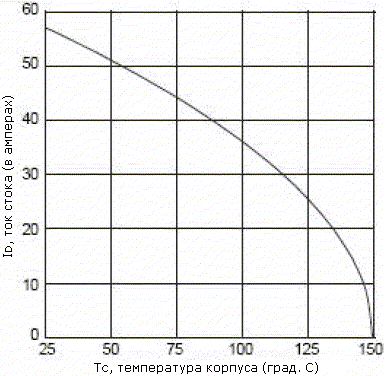
Рис. 6. Максимальный ток стока в зависимости от температуры.
IDM, импульсный ток стока. Этот параметр показывает, какой импульс тока может выдержать устройство. Этот ток может значительно превышать максимально допустимый постоянный ток. Назначение этого параметра IDM состоит в том, чтобы удержать рабочий омический регион в пределе выходных характеристик. Посмотрите на рис. 7:
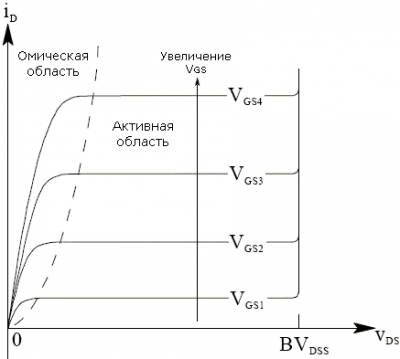
Рис. 7. Выходная характеристика MOSFET.
На этом графике есть максимальный ток стока для соответствующего напряжения затвор-исток, когда транзистор MOSFET открыт. Если рабочая точка при данном напряжении затвор-исток переходит выше омического региона "колена" рис. 7, то любое дальнейшее увеличение тока через сток приведет к значительному увеличению напряжения сток-исток (транзистор переходит из режима насыщения в линейный режим) и последующей потере проводимости. Если мощность рассеивания станет слишком велика, и это будет продолжаться довольно долго, то устройство может выйти из строя. Параметр IDM нужен для того, чтобы установить рабочую точку ниже "колена" для типичных применений транзистора в ключевом режиме.
Нужно ограничить плотность тока, чтобы предотвратить опасный нагрев, что иначе может привести к необратимому перегоранию MOSFET.
Чтобы избежать проблем с превышением тока через соединительные провода иногда применяют плавкие предохранители. В случае перегрузки по току выгорят именно они вместо транзистора.
Относительно температурных ограничений на IDM, рост температуры зависит от длительности импульса тока, интервала времени между импульсами, интенсивности рассеивания тепла, сопротивления открытого канала RDS(on), а также и от формы и амплитуды импульса тока. Если просто удержаться в пределах IDM, то это еще не означает, что температура перехода не будет превышена. См. обсуждение переходного теплового сопротивления в разделе "Температурные и механические характеристики", чтобы узнать способ оценки температуры перехода во время импульса тока.
PD, общая мощность рассеивания. Этот параметр определяет максимальную мощность, которую может рассеивать устройство, и он основан на максимально допустимой температуре перехода и термосопротивлении RӨJC для случая температуры 25°C.

Линейный коэффициент снижения мощности это просто инверсия RӨJC.
TJ, TSTG: рабочий и складской диапазон температур перехода. Этот параметр ограничивает допустимую температуру кристалла устройства во время работы и во время хранения. Установленные пределы гарантируют, что будут соблюдены гарантийные эксплуатационные сроки устройства. Работа в пределах этого диапазона может значительно увеличить срок службы.
EAS, лавинная энергия одиночного импульса. Если импульс напряжения (возникающий обычно из-за утечки и случайной индуктивности) не превышает напряжение пробоя, то не будет лавинного пробоя устройства, так что нет необходимости рассеивать энергию пробоя. Параметр максимальной лавинной энергии оценивает устройство в плане рассеивания мощности режима лавинного пробоя при переходных процессах с повышенным напряжением.
Все устройства, которые оценены по лавинной энергии, имеют параметр EAS. Лавинная энергия связана с параметром разблокированного индуктивного переключения (unclamped inductive switching, UIS). EAS показывает, сколько лавинной энергии устройство может поглотить. Условия для схемы тестирования Вы можете найти в документации по ссылкам, и EAS вычисляется по формуле:

Здесь L величина индуктивности, из которой поступает импульс тока iD, случайно поступающий в на закрытый переход транзистора через сток при тесте. Индуцируемое напряжение превышает напряжение пробоя MOSFET, что вызывает лавинный пробой. Лавинный пробой позволяет импульсу тока от индуктивности течь через MOSFET, даже если он закрыт. Энергия, запасенная в индуктивности, аналогична энергии, сохраненной в утечке и/или случайной индуктивности, и она должна быть рассеяна в MOSFET.
Когда транзисторы MOSFET соединены параллельно, это совершенно не означает, что у них одинаковое напряжение пробоя. Обычно пробьется только один транзистор, и только на него поступит вся энергия тока лавинного пробоя.
EAR, повторная лавинная энергия. Этот параметр стал "промышленным стандартом", но он не имеет смысла без информации о частоте, других потерях и эффективности охлаждения. Рассеивание тепла (охлаждение) часто ограничивает значение повторной рассеиваемой энергии. Также трудно предсказать, сколько энергии находится в лавинном событии. То, о чем говорит EAR в действительности, означает, что устройство может выдерживать повторяющиеся лавинные пробои без какого-либо ограничения по частоте, если устройство не перегрето, что в принципе верно для любого устройства, которое может испытать лавинный пробой. Во время анализа проекта хорошей практикой является измерение температуры устройства или его радиатора во время работы - чтобы увидеть, что MOSFET не перегрет, особенно если возможны условия лавинного пробоя.
IAR, ток лавинного пробоя. Для некоторых устройств, которые могут выйти из строя во время лавинного пробоя, этот параметр дает лимит на максимальный ток пробоя. Так что это как бы "точный отпечаток" спецификаций лавинной энергии, показывающий реальные возможности устройства.
[Статические электрические характеристики]
V(BR)DSS, Drain-source breakdown voltage, напряжение пробоя сток-исток. Параметр V(BR)DSS (иногда его называют BVDSS) определяет максимальное напряжение сток-исток, при котором через канал сток-исток будет течь ток не больше допустимого при заданной температуре и нулевом напряжении между затвором и истоком. Фактически этот параметр соответствует напряжению лавинного пробоя канала сток-исток закрытого транзистора.
Как показано на рис. 8, у параметра V(BR)DSS есть положительный температурный коэффициент. Таким образом, MOSFET может выдержать больше напряжение, если он нагрет, по сравнению с холодным состоянием. Фактически в охлажденном состоянии V(BR)DSS будет меньше, чем предельно допустимое напряжение сток-исток VDSS, указанное для температуры 25°C. В примере, показанном на рис. 8 при -50°C, напряжение V(BR)DSS будет составлять 90% от максимально допустимого VDSS, указанного для температуры 25°C.

Рис. 8. Нормализованная зависимость напряжения пробоя от температуры.
VGS(th), Gate threshold voltage, напряжение отсечки затвора. Это пороговое напряжение сток-исток, при превышении которого транзистор начнет открываться. Т. е. при напряжении на затворе выше VGS(th) транзистор MOSFET начинает проводить ток через канал сток-исток. Для параметра VGS(th) также указываются условия проверки (ток стока, напряжение сток-исток и температура кристалла). Все транзисторы MOSFET допускают некоторый разброс порогового напряжения отсечки затвора от устройства к устройству, что вполне нормально. Таким образом, для VGS(th) указывается диапазон (минимум и максимум), в который должны попасть все устройства указанного типа. Как уже обсуждалось ранее в разделе "На что влияет температура", VGS(th) имеет отрицательный температурный коэффициент. Это значит, что с увеличением нагрева MOSFET откроется при более низком напряжении затвор-исток.
RDS(on), ON resistance, сопротивление в открытом состоянии. Этот параметр определяет сопротивление открытого канала сток-исток при указанном токе (обычно половина от тока ID), напряжении затвор-исток (обычно 10V) и температуре 25°C, если не указано что-либо другое.
IDSS, Zero gate voltage drain current, ток утечки канала. Это ток, который может течь через закрытый канал сток-исток, когда напряжение на затвор-исток равно нулю. Поскольку ток утечки увеличивается с температурой, то IDSS указывается для комнатной температуры и для нагретого состояния. Потери мощности из-за тока утечки IDSS через канал сток-исток обычно незначительны.
IGSS, Gate-source leakage current, ток утечки затвора. Это ток, который может через затвор при указанном напряжении затвор-исток.
[Динамические характеристики]
Рис. 9 показывает месторасположения внутренних емкостей транзистора MOSFET. Величина этих емкостей определяется структурой MOSFET, используемыми материалами и приложенными напряжениями. Эти емкости не зависят от температуры, так что температура не влияет на скорость переключения MOSFET (за исключением незначительного эффекта, связанного с пороговым напряжением, которое зависит от температуры).
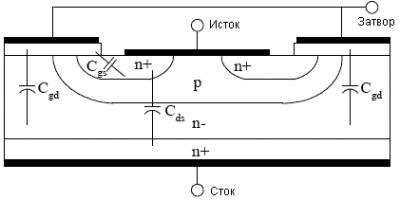
Рис. 9. Паразитные емкости транзистора MOSFET в структуре кристалла.
Емкости Cgs и Cgd меняются в зависимости от приложенного к ним напряжений, потому что они затрагивают обедненные слои в устройстве [8]. Однако на Cgs намного меньше меняется напряжение в сравнении с Cgd, так что емкость Cgs изменяется меньше. Изменение Cgd при изменении напряжения сток-затвор может быть больше, потому что напряжение может меняться в 100 раз или больше.
На рис. 10 показаны внутренние емкости MOSFET с точки зрения схемотехники. Емкости затвор-сток и затвор-исток могут повлиять на схему управления, и вызвать нежелательные эффекты при быстрых переключениях в мостовых схемах.
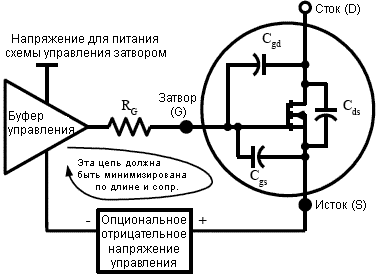
Рис. 10. Паразитные емкости транзистора MOSFET в рабочей схеме
ДАЛЕЕ (Продолжение)

